芯片失效故障定位技术-EMMI&Obirch
发布时间:2025-04-14
光束诱导电阻变化( OBIRCH )功能与光发射( EMMI )常见集成在一个检测系统,合称 PEM ( Photo Emission Microscope) ,两者互为补充,能够很好的应对绝大多数失效模式。
在金属覆盖区域有热点的话,Obirch也可以检测出来。两种都可以进行正面和背面检测,可以在大范围内准确并迅速定位集成电路中的微小失效点,并通过后续的去层处理、电镜扫描和光学显微镜观察,对缺陷进行界定,找出失效机理并进行根因分析,因而在器件和集成电路失效分析中得到广泛应用。
设备原理:
微光显微镜(Emission Microscope, EMMI)是一种常用的芯片失效分析手段,可以用于确认芯片的失效位置。其原理是对样品施加适当电压,失效点会因加速载流子散射或电子-空穴对的复合而释放特定波长的光子,这时光子就能被检测到,从而检测到漏电位置。
Obirch的工作原理是用红外激光束照射IC的特定区域。当激光与IC相互作用时,会产生热量。这种局部加热导致该区域电气路径的电阻发生变化。可以通过测量电阻变化来检测和定位缺陷。
设备应用功能:
主要用来检测芯片内部的金属短路、接触异常、漏电(结漏、氧化物漏、硅晶化相关缺陷引起的漏电)等。在面板显示领域,常用于IC 异常、bonding 异常、TRX short、GOA short, AA 区 short, FPC short等检测分析。
应用优势:
EMMI(InGaAs探测器):针对Device器件的结漏电、热载子、通孔 spiking、氧化层(如 GOX)漏电、Latch up、异物污染有源区、机械损伤等,对低压芯片灵敏度高。
OBRICH:针对金属化系统层面,比如金属线路里的桥接,空洞等,材料、结构上的异常阻值、漏电路径、器件短路损伤等,针对背面分析效果更好。
测试案例:
1.芯片热点观察+FIB切片+SEM观察
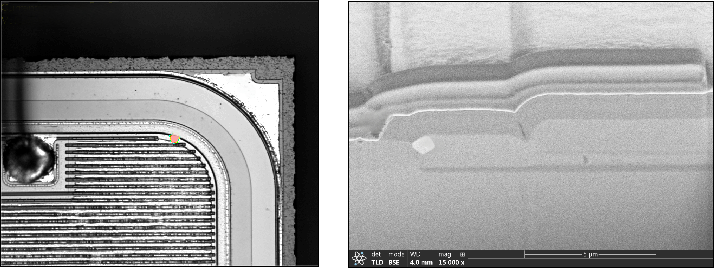
2.器件热点观察+FIB切片+SEM观察
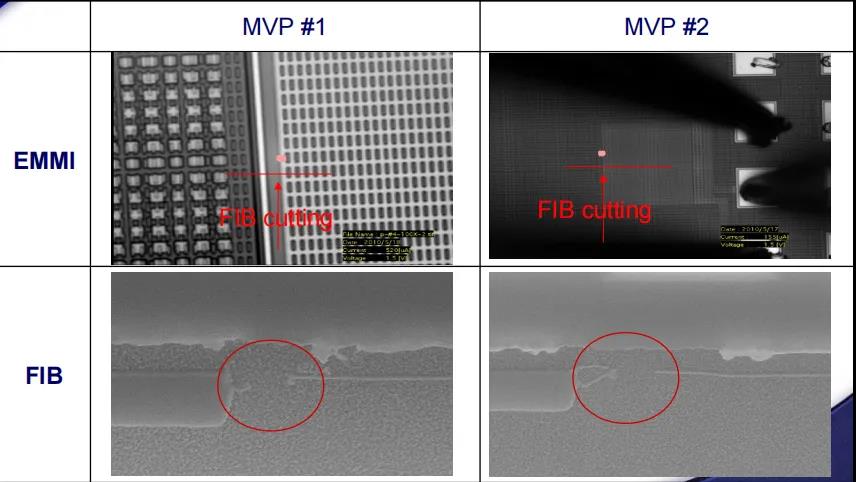
STI corner breakdown was observed at the EMMI spot EMMI热点观察到STI角击穿
3.线路热点分析
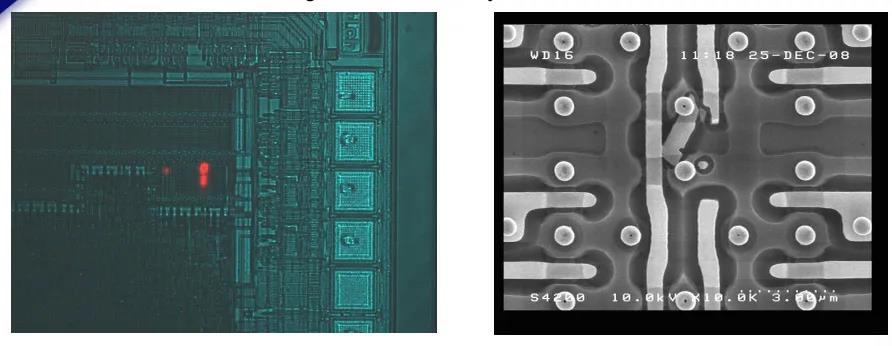
4.器件ESD故障分析
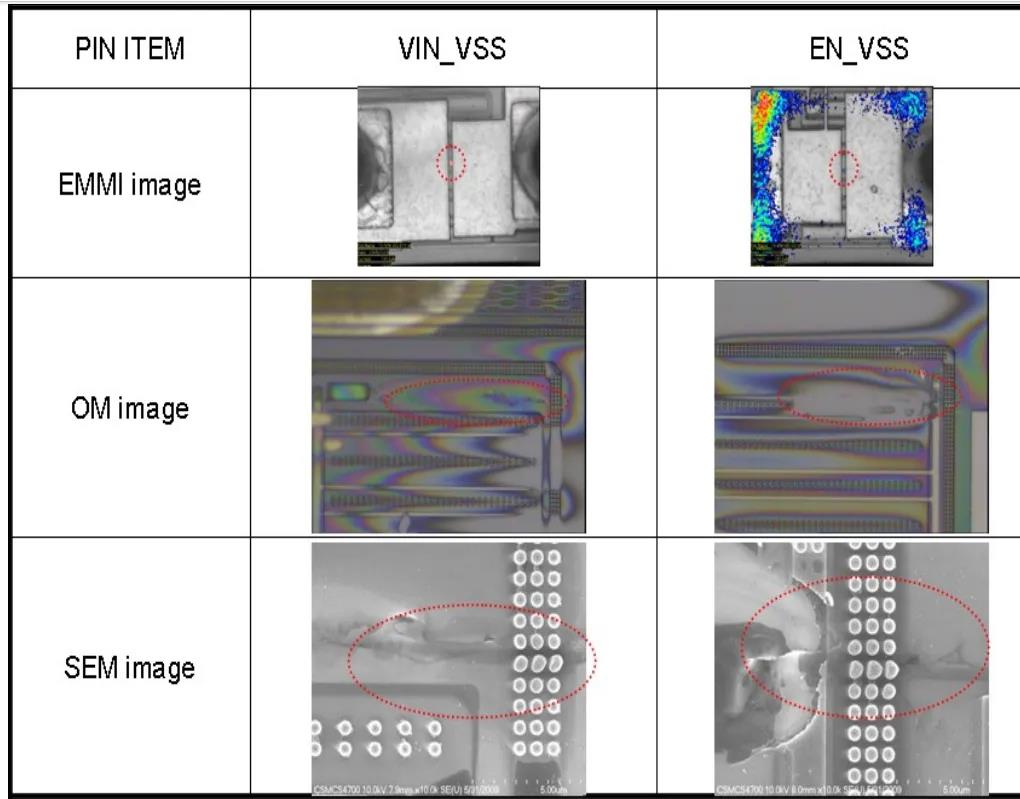
ESD damage was found at specifically position of ESD circuit在电路特定位置发现ESD损坏

 服务热线:400-029-9908
服务热线:400-029-9908





